佳能发售面向后道工艺的3D技术i线半导体光刻机新产品
日期:2022-12-07
佳能将于2023年1月上旬发售面向后道工艺的半导体光刻机新产品——i线※1步进式光刻机“FPA-5520iV LF2 Option”。该产品通过0.8μm(微米※2)的高解像力和拼接曝光技术,使100×100mm的超大视场曝光成为可能,进一步推动3D封装技术的发展。

FPA-5520iV LF2 Option
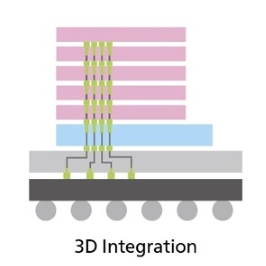
通过半导体芯片层叠而
实现高性能的3D技术(示意图)

将四个曝光shot拼接,
形成一个大型封装(4shot×4个)
为了提高半导体芯片的性能,不仅在半导体制造的前道工艺中实现电路的微细化十分重要,在后道工艺的高密度封装也备受关注,而实现高密度的先进封装则对精细布线提出了更高要求。同时,近年来半导体光刻机得到广泛应用,这一背景下,半导体器件性能的提升,需要通过将多个半导体芯片紧密相连的2.5D技术※3及半导体芯片层叠的3D※4技术来实现。
新产品是通过0.8μm的高解像力和曝光失真较小的4个shot拼接曝光,使100×100mm的超大视场曝光成为可能,从而实现2.5D和3D技术相结合的超大型高密度布线封装的量产。
与以往机型“FPA-5520iV LF Option”(2021年4月发售)相比,本次发售的新产品能够将像差抑制至四分之一以下。新产品搭载全新的投射光学系统、采用照度均一性更佳的照明光学系统,以及0.8μm的解像力和拼接曝光技术,能够在前一代产品52x68mm大视场的基础上,实现向100×100mm超大视场的提升。
新产品同时也继承了半导体光刻机“FPA-5520iV”的多项基本性能。例如可以灵活应对再构成基板※5翘曲等在封装工艺中对量产造成阻碍的问题,以及在芯片排列偏差较大的再构成基板上测出Alignment mark,从而提高生产效率。
在面向半导体芯片制造的前道工艺和后道工艺中,佳能在不断扩充搭载先进封装技术的半导体光刻机产品阵营,持续为半导体设备的技术创新做出贡献。
-
使用了i线(水银灯波长 365nm)光源的半导体光刻设备。1nm(纳米)是10亿分之1米。
- 1µm(微米)是100万分之1米(=1000分之1mm)。
- 在封装基板上设置硅中介层(对半导体芯片与封装基板之间进行电极连接的中介组件),进而排列多个半导体芯片然后紧密相连的技术。
- 通过TSV技术(硅通孔电极技术。为了实现高度集成化,将硅正反面进行通孔贯穿的技术)而实现层叠的技术。
- 从半导体光刻机前道工艺中制造的晶圆中取出多个半导体芯片原件并排列,用树脂固定成晶圆形状的基板。
〈新产品特征〉
1.通过新投射光学系统和照明光学系统的提升,实现0.8μm的高解像力和拼接曝光超大视场
- 为了减少投射光学系统的像差,新产品首次将应用于前道工艺光刻机的校正非球面玻璃搭载在后道工艺的光刻机上。与以往机型“FPA-5520iV LF Option”相比,新产品的像差可控制至四分之一以下,更平顺地实现shot间的拼接。
- 新产品对均质器进行了改良,能够提升照明光学系统的照度均一性,实现52×68 mm大视场中0.8μm的解像力。同时,新产品能够通过四个shot的拼接曝光,实现100×100mm以上的超大视场,进而实现高密度布线封装的量产。

以往机型“FPA-5520iV LF Option”
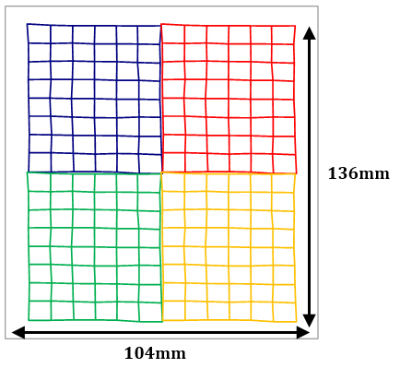
新产品“FPA-5520iV LF Option”
变像像差的改善(示意图)

前道工艺的标准视场26×33mm
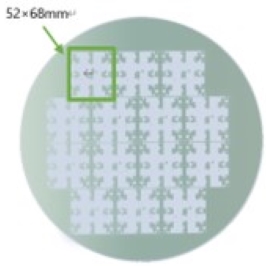
52×68mm曝光(新产品)
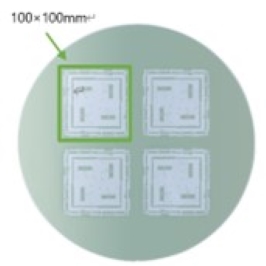
50x50mm 4shot拼接曝光(新产品)
曝光视场示例
2.继承FPA-5520iV的基本性能.
- 新产品继承了“FPA-5520iV”中实现的基本性能。
- 新产品搭载了应对较大翘曲问题的基板搬运系统,可灵活应对目前应用于移动终端封装的主流技术——FOWLP※1中存在的再构成基板出现较大翘曲的问题,这一问题也是实现量产的阻碍。
- 新产品搭载了大视野Alignment scope,针对芯片排列偏差较大的再构成基板,也可以测出Alignment mark。
- 新产品可适用于以芯片为单位进行定位并曝光的Die by Die Alignment技术。

再构成基板的较大翘曲(示意图)

芯片重排列时的偏差(示意图)
-
Fan Out Wafer Level Package的简称。封装技术的一种。有可以应对无基板、封装面积比芯片大且引脚较多的封装等优势。
〈什么是半导体制造的后道工艺〉
在半导体芯片的制造工艺中,半导体光刻机负责“曝光”电路图案。在曝光的一系列工艺中,在硅晶圆上制造出半导体芯片的工艺称为前道工艺。另一方面,保护精密的半导体芯片不受外部环境的影响,并在安装时实现与外部的电气连接的封装工艺称为后道工艺。
〈关于半导体光刻机解说的网站〉
我们发布了“佳能光刻机网站”,通过图片和视频等易于理解的方式说明“光刻机”的原理和性能。此外,我们还面向青少年专门开设了一个页面,帮助他们理解曝光的原理。
〈半导体光刻机的市场动向〉
近年来,随着物联网的飞速发展,以及受新冠疫情影响使远程办公和在线活动持续增加,市场对各种半导体器件的需求也在提升。在这种情况下,除芯片精细化以外,封装的高密度布线也被认为是实现高性能的技术之一。可以预见,随着对更高性能半导体器件的先进封装需求的增加,后道工艺中的半导体光刻机市场将继续扩大。(佳能调研)

俯视示意图

侧视示意图
先进封装技术--2.5D技术与3D技术示意图
〈关于产品规格〉
有关产品规格的详细信息,请参考佳能主页。
-
为方便读者理解,本文中佳能可指代:佳能(中国)有限公司,佳能股份有限公司,佳能品牌等。
上一篇:送礼不如送有趣!

本网站包含一部分广告/市场推广等内容,敬请知悉。


佳能(中国)有限公司版权所有,未经许可不得转载。公司电话:010-85139999
































































































 京公网安备 11010502037877号
京公网安备 11010502037877号